Tombstoning: 预防PCB组装缺陷的策略

随着我们继续探讨常见的印刷电路板组装缺陷以及PCB设计如何影响组装过程的系列文章,让我们更深入地了解一下“墓碑现象”。有时候,我们在电子制造中使用的术语让我觉得有趣。看起来我们可以为墓碑现象、鼠咬、兔耳等术语找到更高科技的名称,但我不得不承认,这些术语不仅非常形象,而且也容易记住。
如果你不熟悉“墓碑现象”,它发生在表面贴装元件的一端在焊接回流过程中从焊盘上抬起,最终呈现出类似墓碑的直立位置。墓碑现象的常见原因包括焊膏沉积不均、焊盘尺寸变化、回流过程中热剖面不一致以及PCB设计问题,如铜线迹不均或焊膏覆盖不足。其中一些问题可以通过PCB设计来影响,其他则是组装过程控制的结果。
在印刷电路板组装中,特别是在表面贴装技术(SMT)组装过程中,墓碑现象是一个相对常见的问题。虽然墓碑现象的发生频率可能因使用的特定元件、PCB设计的复杂性以及制造过程的质量等因素而有所不同,但墓碑现象被认为是PCB组装过程中遇到的较为普遍的缺陷之一。
尽管制造技术的进步和改进的设计实践已经帮助减少了墓碑现象的发生率,但它仍然是PCB设计师和制造商必须解决的挑战,以确保电子设备的可靠性和功能性。在汽车、航空航天和医疗设备制造等要求高可靠性标准的行业中,人们努力最小化墓碑现象的发生。目标是消除需要为了消除墓碑现象而进行的返工。
导致墓碑现象的因素
- 焊膏沉积方法,例如焊膏印刷,必须经过验证以确保在焊盘上均匀沉积焊膏。
- 不均匀的防焊层覆盖:防焊层作为PCB上的保护层,防止在回流焊过程中焊料流向不应该流向的地方。如果一个元件一侧的焊盘比其他焊盘的防焊层覆盖少,结果可能是焊接不均匀和立碑现象。
- PCB上焊盘的设计和尺寸在防止立碑现象中起着至关重要的作用。如果焊盘太小、太大或每侧元件的焊盘不匹配,可能导致焊接不均。例如,较小的焊盘可能无法提供足够的表面积以进行适当的焊料粘附,而较大的焊盘可能导致过量的焊膏和回流过程中的不平衡。
- 确保焊盘尺寸适合所使用的元件,提供足够的表面积以进行焊料粘附而无需过量焊料。
- 实施适当的焊盘几何形状,如圆角或倒角边缘,以促进一致的焊料流动并最小化焊料桥接或立碑风险。
- 对连接到大铜平面的元件使用热释放焊盘,以减轻回流焊过程中的热不平衡。
- 元件的准确放置:放置过程中的错位可能导致回流焊过程中不均匀加热,导致元件的一端先于另一端焊接。
防焊层考虑因素
适当的防焊层覆盖对于防止焊料桥接和立碑至关重要。DFM实践建议:
- 确保焊盘周围有足够的防焊层覆盖,以防止在回流焊过程中焊料流向不应该流向的地方。
- 实施防焊层扩展,以在焊盘之间提供额外的间隙,防止焊料桥接。
- 执行设计审查以验证防焊层覆盖并根据需要进行调整,以最小化立碑风险。
热释放策略
有效的热释放策略有助于在回流焊过程中管理热分布,减少立碑的可能性。DFM指南建议:
- 对连接到大铜平面的元件使用热释放连接,以最小化热梯度并防止立碑。
- 根据元件的热需求和PCB的布局,优化热释放连接的数量和位置。
DFM分析工具
- 使用DFM分析工具可以帮助在设计过程早期识别潜在问题并防止立碑。设计师可以:
- 执行热模拟以评估PCB上的热分布并识别易于立碑的区域。
- 进行设计规则检查(DRCs)和可制造性检查,以确保符合DFM指南并识别潜在的立碑风险。
随着元件微型化的进步,SMT装配过程正面临压力,人们正在努力解决为应对这些更紧密的特征尺寸所需的过程调整。在回流焊过程中保持一致的热曲线,包括升温、浸泡和冷却阶段,可以帮助防止石墓现象。可以公平地假设,在此过程中,我们将看到常见的印刷电路板装配缺陷,如石墓现象的增加。与您的制造团队合作,了解可制造性设计指南中的任何变化将是至关重要的。
关于作者
关于作者
Tara是一位公认的行业专家,在以下领域拥有20多年的工作经验:PCB工程师、设计师、制造商、采购组织和印刷电路板用户。她的专长是刚柔结合板、增材技术和快速交付项目。她掌握行业最顶级的资源,可通过个人技术参考网站PCBadvisor.com快速掌握各种主题,并经常以演讲者的身份参与行业活动,在PCB007.com杂志上撰文,并运营Geek-a-palooza.com网站。她的公司Omni PCB以当天及时响应以及能够满足特殊规格(交货时间、技术和数量)要求完成项目而闻名。
相关资源
相关的技术文档

PCB Manufacturing Handoff Tools
Faster design-to-production handoff with your contract manufacturer.

Manufacturing Made Easy
Centralize DFM reviews and packages to accelerate PCB production handoff.

PCB Design
Equip engineers with everything needed to design modern, high-performance PCBs.

Product Design
Combine advanced PCB design with cloud-based collaboration to streamline development.








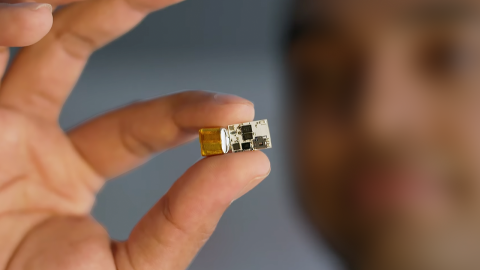


 沪公网安备 31010502006411号
沪公网安备 31010502006411号